
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe in Chip Manufacturing: Ammattimainen uutisraportti
Puolijohdemateriaalien evoluutio
Nykyaikaisen puolijohdeteknologian alalla säälimätön pyrkimys miniatyrisoida on työntänyt perinteisten piipohjaisten materiaalien rajoja. Vastatakseen korkean suorituskyvyn ja alhaisen virrankulutuksen vaatimuksiin SiGe (Silicon Germanium) on noussut suosimaksi komposiittimateriaaliksi puolijohdesirujen valmistuksessa ainutlaatuisten fysikaalisten ja sähköisten ominaisuuksiensa ansiosta. Tässä artikkelissa perehdytäänepitaksiprosessiSiGe ja sen rooli epitaksiaalisessa kasvussa, jännittyneessä piisovelluksissa ja Gate-All-Around (GAA) -rakenteissa.
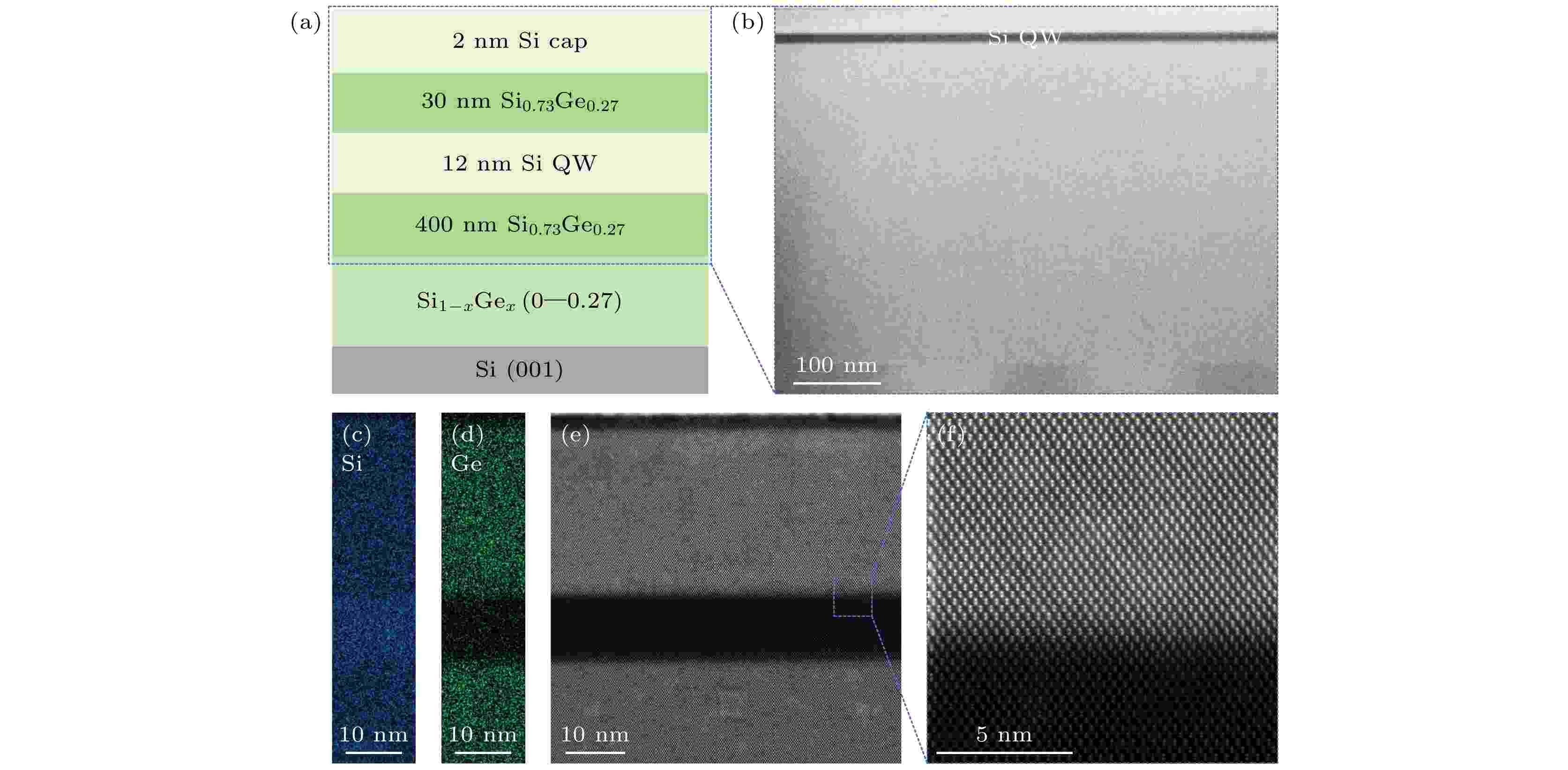
SiGe-epitaksian merkitys
1.1 Johdatus epitaksiin sirujen valmistuksessa:
Epitaksia, usein lyhennettynä nimellä Epi, viittaa yksikidekerroksen kasvuun yksikidealustalle samalla hilajärjestelyllä. Tämä kerros voi olla jokohomoepitaksiaalinen (kuten Si/Si)tai heteroepitaksiaalinen (kuten SiGe/Si tai SiC/Si). Erilaisia menetelmiä käytetään epitaksiaaliseen kasvuun, mukaan lukien molekyylisuihkuepitaksi (MBE), ultrakorkea tyhjiökemiallinen höyrypinnoitus (UHV/CVD), atmosfäärinen ja alennettu paineepitaksi (ATM & RP Epi). Tämä artikkeli keskittyy piin (Si) ja pii-germaniumin (SiGe) epitaksiprosesseihin, joita käytetään laajalti integroitujen puolijohdepiirien tuotannossa piin ollessa substraattimateriaalina.
1.2 SiGe Epitaxyn edut:
Sisältävät tietyn osan germaniumia (Ge) aikanaepitaksiprosessimuodostaa SiGe-yksikidekerroksen, joka ei vain pienennä kaistan leveyttä, vaan myös lisää transistorin rajataajuutta (fT). Tämä tekee siitä laajan käyttökelpoisen langattoman ja optisen viestinnän suurtaajuisissa laitteissa. Lisäksi edistyneissä integroiduissa CMOS-piiriprosesseissa hila-epäsopivuus (noin 4 %) Ge:n ja Si:n välillä aiheuttaa hilajännitystä, mikä lisää elektronien tai reikien liikkuvuutta ja lisää siten laitteen kyllästysvirtaa ja vastenopeutta.
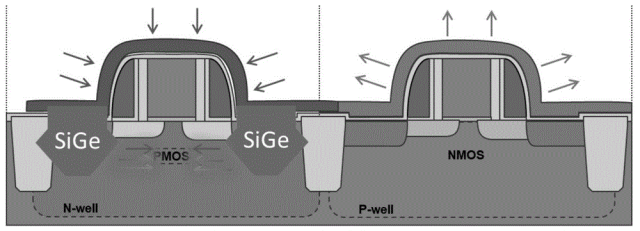
Kattava SiGe-epitaksiprosessin kulku
2.1 Esikäsittely:
Piikiekkoja esikäsitellään haluttujen prosessitulosten perusteella, mikä tarkoittaa ensisijaisesti luonnollisen oksidikerroksen ja epäpuhtauksien poistamista kiekon pinnalta. Voimakkaasti seostettujen substraattikiekkojen kohdalla on ratkaisevan tärkeää harkita, onko taustatiivistys tarpeen automaattisen dopingin vähentämiseksi myöhempien aikana.epitaksinen kasvu.
2.2 Kasvukaasut ja -olosuhteet:
Piikaasut: Silaani (SiH4), dikloorisilaani (DCS, SiH2Cl2) ja trikloorisilaani (TCS, SiHCl3) ovat kolme yleisimmin käytettyä piikaasun lähdettä. SiH₄ soveltuu matalan lämpötilan täysepitaksiprosesseihin, kun taas nopeasta kasvustaan tunnettua TCS:ää käytetään laajalti paksujensilikoni epitaksikerroksia.
Germaniumkaasu: Germane (GeH₄) on ensisijainen germaniumin lisäämisen lähde, jota käytetään yhdessä piilähteiden kanssa SiGe-seosten muodostamiseen.
Selektiivinen epitaksia: Selektiivinen kasvu saavutetaan säätämällä suhteellisia nopeuksiaepitaksiaalinen kerrostuminenja in situ -etsaus käyttäen klooripitoista DCS-piikaasua. Selektiivisyys johtuu siitä, että Cl-atomien adsorptio piipinnalla on pienempi kuin oksideissa tai nitrideissä, mikä helpottaa epitaksiaalista kasvua. SiH4:ää, josta puuttuu Cl-atomeja ja jolla on alhainen aktivaatioenergia, käytetään yleensä vain matalan lämpötilan täysepitaksiprosesseihin. Toisella yleisesti käytetyllä piilähteellä, TCS:llä, on alhainen höyrynpaine ja se on nestemäistä huoneenlämpötilassa, mikä vaatii H2:n kuplittamista sen viemiseksi reaktiokammioon. Se on kuitenkin suhteellisen halpa, ja sitä käytetään usein nopean kasvun (jopa 5 μm/min) vuoksi paksumpien piiepitaksiakerrosten kasvattamiseen, jota käytetään laajalti pii-epitaksikiekkojen tuotannossa.
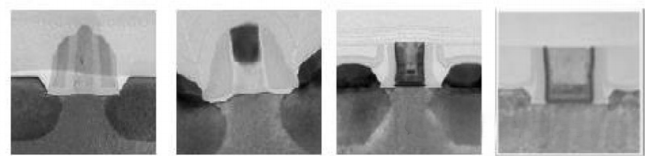
Jännittynyt silikoni epitaksiaalisissa kerroksissa
Aikanaepitaksiaalinen kasvu, epitaksiaalinen yksikiteinen Si kerrostetaan relaksoidulle SiGe-kerrokselle. Si:n ja SiGe:n välisen ristikon yhteensopimattomuuden vuoksi Si-yksikidekerrokseen kohdistuu vetojännitys alla olevasta SiGe-kerroksesta, mikä lisää merkittävästi elektronien liikkuvuutta NMOS-transistoreissa. Tämä tekniikka ei vain lisää kyllästysvirtaa (Idsat), vaan myös parantaa laitteen vastenopeutta. PMOS-laitteissa SiGe-kerroksia kasvatetaan epitaksiaalisesti lähde- ja valuma-alueilla syövytyksen jälkeen puristusjännityksen aikaansaamiseksi kanavaan, mikä parantaa reiän liikkuvuutta ja lisää kyllästysvirtaa.
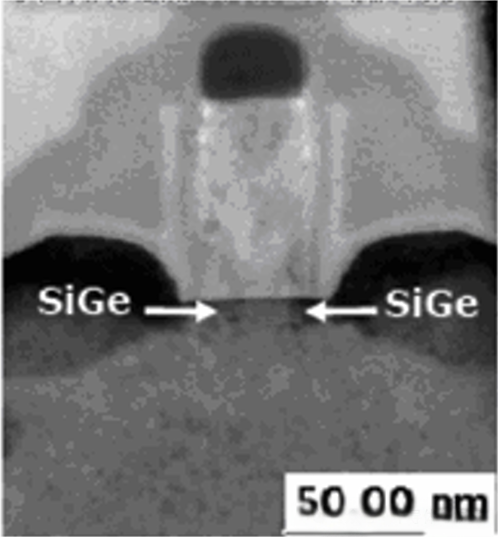
SiGe uhrautuvana kerroksena GAA-rakenteissa
Gate-All-Around (GAA) nanolankatransistoreiden valmistuksessa SiGe-kerrokset toimivat uhrautuvana kerroksina. Korkean selektiivisyyden anisotrooppiset syövytystekniikat, kuten kvasiatomikerrosetsaus (quasi-ALE), mahdollistavat SiGe-kerrosten tarkan poistamisen nanolanka- tai nanolevyrakenteiden muodostamiseksi.
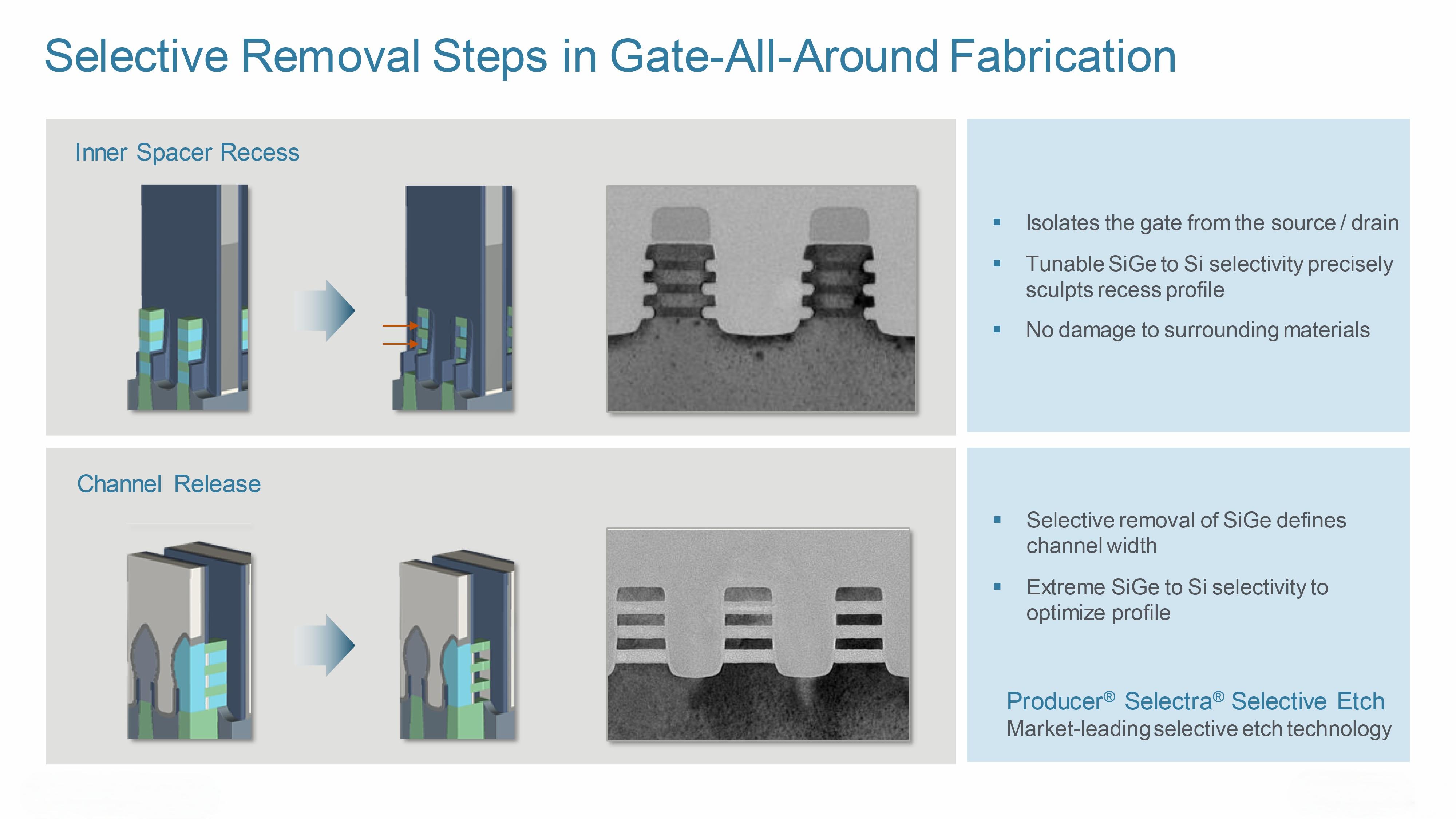
Me Semicorexilla olemme erikoistuneetSiC/TaC-pinnoitetut grafiittiliuoksetsovellettu Si epitaksiaaliseen kasvuun puolijohteiden valmistuksessa, jos sinulla on kysyttävää tai tarvitset lisätietoja, älä epäröi ottaa meihin yhteyttä.
Yhteyspuhelin: +86-13567891907
Sähköposti: sales@semicorex.com




