
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Puolijohdelaitteiden täydellisen valmistusprosessin ymmärtäminen
1. Fotolitografia
Fotolitografia, usein synonyymi kuvioiden luomiselle, on yksi kriittisimmistä liikkeellepanevista voimista puolijohdetekniikan nopean kehityksen takana. Se on peräisin valokuvauslevyjen valmistusprosesseista painatuksessa. Tämä tekniikka mahdollistaa minkä tahansa kuvion esittämisen mikro- tai nanomittakaavassa. fotoresist, ja yhdistettynä muihin prosessiteknologioihin siirtää nämä kuviot materiaaleille toteuttaen erilaisia puolijohdemateriaalien ja -laitteiden malleja ja konsepteja. Fotolitografiassa käytetty valonlähde vaikuttaa suoraan kuvioiden tarkkuuteen. Vaihtoehdot vaihtelevat ultravioletti-, syvä-ultravioletista röntgen- ja elektronisäteeseen, joista kukin vastaa kuvion tarkkuuden lisääntymistä mainitussa järjestyksessä.
Tavallinen fotolitografiaprosessi sisältää pinnan esikäsittelyn, adheesion, pehmeän paiston, valotuksen, valotuksen jälkeisen paistamisen, kehitystyön, kovapaistuksen ja tarkastuksen.
Pintakäsittely on välttämätöntä, koska substraatit tyypillisesti imevät H2O-molekyylejä ilmasta, mikä on haitallista fotolitografialle. Siksi alustat läpikäyvät aluksi kuivauskäsittelyn paistamisen kautta.
Hydrofiilisillä substraateilla niiden adheesio hydrofobiseen fotoresistiin on riittämätön, mikä saattaa aiheuttaa fotoresistin irtoamisen tai kuvion vääristymisen, jolloin tarvitaan tarttumista edistävää ainetta. Tällä hetkellä heksametyylidisilatsaani (HMDS) ja tri-metyylisilyylidietyyliamiini (TMSDEA) ovat laajalti käytettyjä adheesion tehostajia.
Pintakäsittelyn jälkeen fotoresistin levitys alkaa. Käytetyn fotoresistin paksuus ei liity ainoastaan sen viskositeettiin, vaan siihen vaikuttaa myös spin-pinnoitusnopeus, yleensä kääntäen verrannollinen linkousnopeuden neliöjuureen. Päällystyksen jälkeen suoritetaan pehmeä paistaminen liuottimen haihduttamiseksi fotoresististä, mikä parantaa adheesiota prosessissa, joka tunnetaan nimellä esipaisto.
Kun nämä vaiheet on suoritettu, valotus tapahtuu. Fotoresistit luokitellaan positiivisiksi tai negatiivisiksi, ja niillä on vastakkaiset ominaisuudet altistuksen jälkeen.
Otetaan esimerkkinä positiivinen fotoresisti, jossa valottamaton fotoresisti ei liukene kehittimeen, mutta liukenee valotuksen jälkeen. Valotuksen aikana valonlähde, joka kulkee kuvioidun maskin läpi, valaisee päällystetyn alustan ja kuvioi fotoresistin. Yleensä substraatti on kohdistettava maskiin ennen altistamista, jotta valotusasentoa voidaan hallita tarkasti. Altistuksen kestoa on hallittava tarkasti kuvion vääristymisen estämiseksi. Altistuksen jälkeen saatetaan tarvita lisäpaistamista seisovien aaltojen vaikutusten lieventämiseksi, vaikka tämä vaihe on valinnainen ja voidaan ohittaa suoran kehityksen hyväksi. Kehitys liuottaa valotetun fotoresistin siirtäen maskin kuvion tarkasti fotoresistikerrokselle. Kehitysaika on myös kriittinen – liian lyhyt johtaa epätäydelliseen kehitykseen, liian pitkä aiheuttaa kuvion vääristymistä.
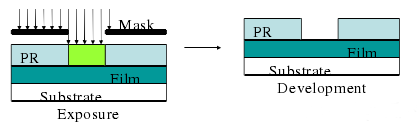
Tämän jälkeen kova paistaminen vahvistaa fotoresistikalvon kiinnittymistä alustaan ja parantaa sen etsauskestävyyttä. Kovan paiston lämpötila on yleensä hieman korkeampi kuin esipaiston lämpötila.
Lopuksi mikroskooppinen tarkastus varmistaa, vastaako kuvio odotuksia. Kun kuvio on siirretty materiaalille muilla prosesseilla, fotoresisti on täyttänyt tehtävänsä ja se on poistettava. Irrotusmenetelmiä ovat märkä (käyttämällä vahvoja orgaanisia liuottimia, kuten asetonia) ja kuivaa (käyttäen happiplasmaa kalvon syövytykseen).
2. Dopingtekniikat
Doping on välttämätön puolijohdeteknologiassa, mikä muuttaa puolijohdemateriaalien sähköisiä ominaisuuksia tarpeen mukaan. Yleisiä dopingmenetelmiä ovat lämpödiffuusio ja ioni-istutus.
(1) Ioni-istutus
Ioni-istutus dopi puolijohdesubstraatin pommittamalla sitä korkeaenergisilla ioneilla. Lämpödiffuusioon verrattuna sillä on monia etuja. Massa-analysaattorilla valitut ionit varmistavat korkean seostuspuhtauden. Koko implantoinnin ajan substraatti pysyy huoneenlämpötilassa tai hieman sen yläpuolella. Voidaan käyttää monia peitekalvoja, kuten piidioksidia (SiO2), piinitridiä (Si3N4) ja fotoresistiä, jotka tarjoavat suuren joustavuuden itsekohdistuvilla maskitekniikoilla. Implanttiannoksia kontrolloidaan tarkasti, ja implantoitujen epäpuhtauksien ionejakauma on tasainen samassa tasossa, mikä johtaa suureen toistettavuuteen.
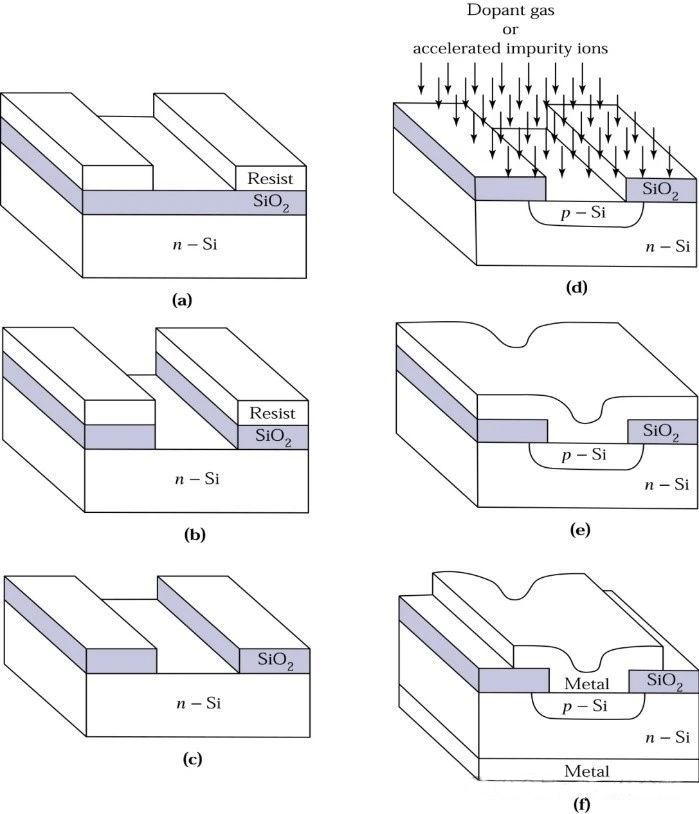
Implantaatiosyvyyden määrää ionien energia. Energiaa ja annosta säätelemällä voidaan manipuloida epäpuhtausionien jakautumista substraatissa istutuksen jälkeen. Useita implantaatioita erilaisilla menetelmillä voidaan suorittaa jatkuvasti erilaisten epäpuhtausprofiilien saavuttamiseksi. Erityisesti yksikiteisissä substraateissa, jos implantointisuunta on yhdensuuntainen kristallografisen suunnan kanssa, tapahtuu kanavointivaikutuksia - jotkut ionit kulkevat kanavia pitkin, mikä tekee syvyyden hallinnasta haastavaa.
Kanavoitumisen estämiseksi implantointi suoritetaan tyypillisesti noin 7° kulmassa yksikiteisen substraatin pääakseliin nähden tai peittämällä alusta amorfisella kerroksella.
Ioni-istutus voi kuitenkin merkittävästi vahingoittaa substraatin kiderakennetta. Korkeaenergiset ionit siirtävät törmäyksessä energiaa substraatin ytimiin ja elektroneihin, jolloin ne poistuvat hilasta ja muodostavat interstitiaali-vakanssivirhepareja. Vaikeissa tapauksissa joidenkin alueiden kiderakenne voi tuhoutua, jolloin muodostuu amorfisia vyöhykkeitä.
Hilavaurio vaikuttaa suuresti puolijohdemateriaalin sähköisiin ominaisuuksiin, kuten heikentää kantoaallon liikkuvuutta tai epätasapainoisten kantajien käyttöikää. Mikä tärkeintä, suurin osa implantoiduista epäpuhtauksista on epäsäännöllisissä interstitiaalisissa paikoissa, eivätkä ne pysty muodostamaan tehokasta dopingia. Siksi istutuksen jälkeinen hilavaurion korjaaminen ja epäpuhtauksien sähköinen aktivointi ovat välttämättömiä.
(2)Rapid Thermal Processing (RTP)
Lämpöhehkutus on tehokkain tapa korjata ioni-istutusten ja sähköisesti aktivoivien epäpuhtauksien aiheuttamia hilavaurioita. Korkeissa lämpötiloissa substraatin kidehilassa olevat väli-vakanssivikaparit yhdistyvät ja katoavat; amorfiset alueet myös uudelleenkiteytyvät yksikidealueiden rajalta kiinteän faasin epitaksian kautta. Jotta alustamateriaali ei hapettuisi korkeissa lämpötiloissa, lämpöhehkutus on suoritettava tyhjiössä tai inertissä kaasuilmakehässä. Perinteinen hehkutus kestää kauan ja voi aiheuttaa merkittävää epäpuhtauksien uudelleenjakautumista diffuusion vuoksi.
TuleminenRTP-tekniikkakäsittelee tätä ongelmaa ja saa aikaan suurelta osin hilavaurion korjauksen ja epäpuhtauksien aktivoinnin lyhennetyn hehkutusajan sisällä.
Lämmönlähteestä riippuen,RTPon luokiteltu useisiin tyyppeihin: elektronisuihkupyyhkäisy, pulssielektroni- ja ionisäteet, pulssilaserit, jatkuvan aallon laserit ja laajakaistaiset epäkoherentit valonlähteet (halogeenilamput, grafiittilämmittimet, kaarilamput), joista jälkimmäinen on yleisimmin käytetty. Nämä lähteet voivat lämmittää substraatin vaadittuun lämpötilaan hetkessä, jolloin hehkutus saatetaan päätökseen lyhyessä ajassa ja vähentää tehokkaasti epäpuhtauksien diffuusiota.
3. Kalvon pinnoitustekniikat
(1) Plasma Enhanced Chemical Vapor Deposition (PECVD)
PECVD on yksi kemiallisen höyrypinnoitustekniikan (CVD) muoto kalvopinnoitusta varten, ja kaksi muuta ovat Atmospheric Pressure CVD (APCVD) ja Low Pressure CVD (LPCVD).
Tällä hetkellä PECVD on laajimmin käytetty kolmesta tyypistä. Se käyttää radiotaajuista (RF) plasmaa käynnistämään ja ylläpitämään kemiallisia reaktioita suhteellisen alhaisissa lämpötiloissa, mikä helpottaa kalvon laskeutumista matalassa lämpötilassa korkeilla kerrostumisnopeuksilla. Sen laitteistokaavio on kuvan mukainen.
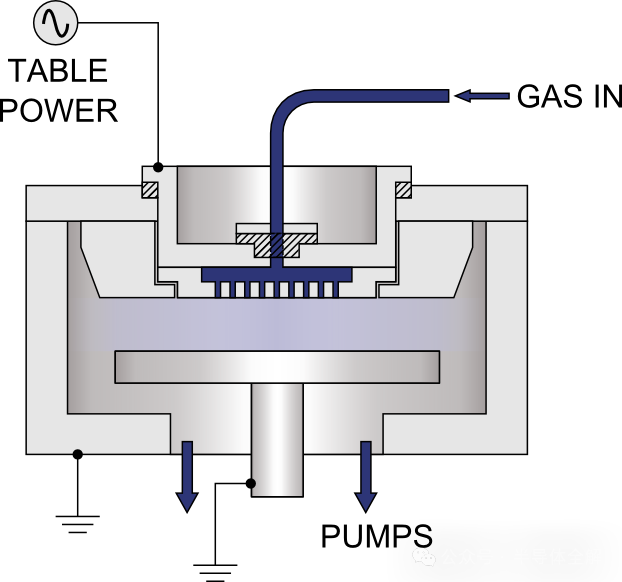
Tällä menetelmällä valmistetuilla kalvoilla on poikkeukselliset adheesiot ja sähköiset ominaisuudet, minimaalinen mikrohuokoisuus, korkea tasaisuus ja vankat pienimuotoiset täyttöominaisuudet. PECVD-pinnoituksen laatuun vaikuttavia tekijöitä ovat alustan lämpötila, kaasun virtausnopeus, paine, RF-teho ja taajuus.
(2) Sputterointi
Sputterointi on fyysinen höyrypinnoitus (PVD) -menetelmä. Varautuneet ionit (yleensä Argon-ionit, Ar+) kiihtyvät sähkökentässä, jolloin ne saavat kineettistä energiaa. Ne suunnataan kohdemateriaalia kohti, törmääen kohdemolekyyleihin ja aiheuttaen niiden irtoamisen ja roiskumisen pois. Näillä molekyyleillä on myös merkittävää kineettistä energiaa ja ne liikkuvat kohti substraattia kerrostuen sen päälle.

Tyypillisesti käytettyjä sputterointiteholähteitä ovat tasavirta (DC) ja radiotaajuus (RF), joissa DC-sputterointi on suoraan sovellettavissa johtaviin materiaaleihin, kuten metalleihin, kun taas eristysmateriaalit vaativat RF-sputterointia kalvopinnoitusta varten.
Perinteinen sputterointi kärsii alhaisista kerrostumisnopeuksista ja korkeista työpaineista, mikä heikentää kalvon laatua. Magnetronisputterointi ratkaisee nämä ongelmat ihanteellisemmin. Se käyttää ulkoista magneettikenttää ionien lineaarisen liikeradan muuttamiseen magneettikentän suunnan ympäri kiertävälle kierteelle, pidentää niiden reittiä ja parantaa törmäystehokkuutta kohdemolekyylien kanssa, mikä parantaa sputterointitehokkuutta. Tämä johtaa lisääntyneisiin kerrostumisnopeuksiin, pienempiin työpaineisiin ja merkittävästi parantuneeseen kalvon laatuun.
4. Etsaus Tekniikat
Etsaus luokitellaan kuiva- ja märkämoodiin, jotka on nimetty niiden käytön (tai puuttumisen) perusteella.
Tyypillisesti syövytys vaatii maskikerroksen (joka voi olla suoraan fotoresistinen) valmistelua suojaamaan alueita, joita ei ole tarkoitettu etsaukseen.
(1) Kuivaetsaus
Yleisiä kuivaetsaustyyppejä ovat mmInduktiivisesti kytketty plasma (ICP) etsaus, Ion Beam Etching (IBE) ja Reactive Ion Etching (RIE).
ICP-etsauksessa hehkupurkauksen tuottama plasma sisältää lukuisia kemiallisesti erittäin aktiivisia vapaita radikaaleja (vapaita atomeja, molekyylejä tai atomiryhmiä), jotka reagoivat kemiallisesti kohdemateriaalin kanssa muodostaen haihtuvia tuotteita, jolloin saadaan aikaan etsaus.
IBE käyttää korkeaenergisiä ioneja (ionisoituja inertistä kaasusta) pommittamaan suoraan kohdemateriaalin pintaa syövytystä varten, mikä edustaa fysikaalista prosessia.
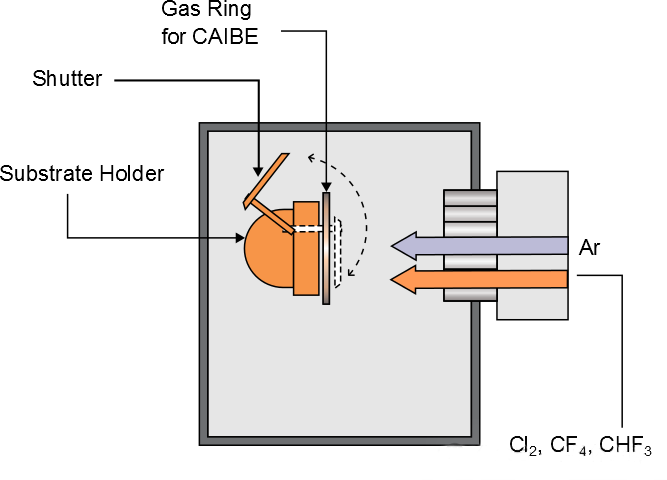
RIE:tä pidetään kahden edellisen yhdistelmänä, joka korvaa IBE:ssä käytetyn inertin kaasun ICP-etsauksessa käytetyllä kaasulla ja muodostaa siten RIE:n.
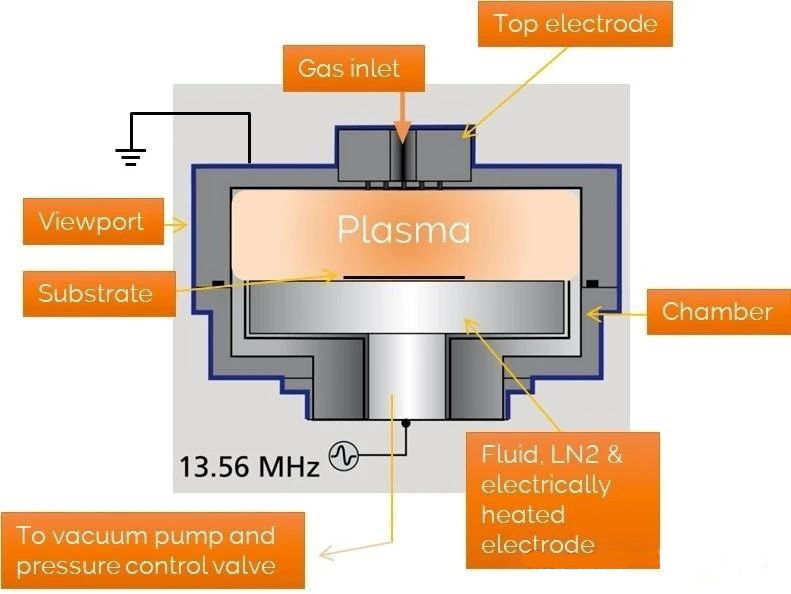
Kuivaetsauksessa pystysyövytysnopeus ylittää huomattavasti lateraalinopeuden, eli sillä on korkea kuvasuhde, mikä mahdollistaa maskikuvion tarkan replikoinnin. Kuivaetsaus kuitenkin syövyttää myös maskikerroksen, mikä osoittaa heikompaa selektiivisyyttä (kohdemateriaalin etsausnopeuksien suhde maskikerrokseen), erityisesti IBE:llä, joka saattaa etsahtaa epäselektiivisesti materiaalin pinnan poikki.
(2) Märkäetsaus
Märkäsyövytys tarkoittaa etsausmenetelmää, joka saadaan aikaan upottamalla kohdemateriaali liuokseen (etsausaine), joka reagoi sen kanssa kemiallisesti.
Tämä etsausmenetelmä on yksinkertainen, kustannustehokas ja osoittaa hyvää selektiivisyyttä, mutta sillä on alhainen kuvasuhde. Maskin reunojen alla oleva materiaali voi ruostua, mikä tekee siitä vähemmän tarkkaa kuin kuivaetsaus. Pienen kuvasuhteen negatiivisten vaikutusten vähentämiseksi on valittava sopivat etsausnopeudet. Syövytysnopeuteen vaikuttavia tekijöitä ovat etsausaineen pitoisuus, etsausaika ja etsausaineen lämpötila.**




