
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Kuivaetsaustekniikan ymmärtäminen puolijohdeteollisuudessa
Etsaus viittaa tekniikkaan, jolla materiaali poistetaan valikoivasti fysikaalisilla tai kemiallisilla keinoilla suunniteltujen rakenteellisten kuvioiden saavuttamiseksi.
Tällä hetkellä monet puolijohdelaitteet käyttävät mesa-laiterakenteita, jotka on pääasiassa luotu kahden tyyppisen syövytyksen avulla:märkäetsaus ja kuivaetsaus. Vaikka yksinkertaisella ja nopealla märkäetsauksella on merkittävä rooli puolijohdelaitteiden valmistuksessa, sillä on luontaisia haittoja, kuten isotrooppinen syövytys ja huono yhtenäisyys, mikä johtaa rajoitettuun ohjaukseen siirrettäessä pienikokoisia kuvioita. Kuivaetsaus korkealla anisotropialla, hyvällä yhtenäisyydellä ja toistettavuudella on kuitenkin noussut näkyväksi puolijohdelaitteiden valmistusprosesseissa. Termi "kuivaetsaus" tarkoittaa laajasti mitä tahansa ei-märkäetsaustekniikkaa, jota käytetään pintamateriaalien poistamiseen ja mikro- ja nanokuvioiden siirtämiseen, mukaan lukien laseretsaus, plasmaetsaus ja kemiallinen höyryetsaus. Tässä tekstissä käsitelty kuivaetsaus koskee erityisesti sellaisten prosessien kapeaa soveltamista, joissa käytetään plasmapurkausta – joko fysikaalista tai kemiallista – materiaalin pintojen muokkaamiseen. Se kattaa useita yleisiä teollisia etsaustekniikoita, mukaan lukienIonisädeetsaus (IBE), reaktiivinen ionietsaus (RIE), elektronisyklotroniresonanssi (ECR) plasmaetsaus ja induktiivisesti kytketty plasma (ICP) etsaus.
1. Ionisädeetsaus (IBE)
IBE, joka tunnetaan myös nimellä ionijyrsintä, kehitettiin 1970-luvulla puhtaasti fysikaaliseksi etsausmenetelmäksi. Prosessi sisältää inertistä kaasusta (kuten Ar, Xe) luotuja ionisäteitä, joita kiihdytetään jännitteellä pommittamaan kohdemateriaalin pintaa. Ionit siirtävät energiaa pintaatomeihin, jolloin ne, joiden energia ylittää niiden sitoutumisenergian, roiskuvat pois. Tämä tekniikka käyttää kiihdytettyä jännitettä ionisäteen suunnan ja energian ohjaamiseen, mikä johtaa erinomaiseen etsauksen anisotropiaan ja nopeuden hallintaan. Vaikka se sopii ihanteellisesti kemiallisesti stabiilien materiaalien, kuten keramiikan ja tiettyjen metallien, etsaukseen, paksumpien naamarien tarve syvemmille syövytyksille voi vaarantaa syövytyksen tarkkuuden, ja suurienerginen ionipommitus voi aiheuttaa väistämättömiä sähkövaurioita hilahäiriöiden vuoksi.

2. Reaktiivinen ionietsaus (RIE)
IBE:n kehittämä RIE yhdistää kemialliset reaktiot fysikaaliseen ionipommitukseen. Verrattuna IBE:hen, RIE tarjoaa korkeammat etsausnopeudet ja erinomaisen anisotropian ja tasaisuuden suurilla alueilla, mikä tekee siitä yhden laajimmin käytetyistä etsaustekniikoista mikro- ja nanovalmistuksessa. Prosessi sisältää radiotaajuisen (RF) jännitteen kohdistamisen rinnakkaisiin levyelektrodeihin, jolloin kammiossa olevat elektronit kiihdyttävät ja ionisoivat reaktiokaasuja, mikä johtaa vakaaseen plasmatilaan levyjen toisella puolella. Plasma kantaa positiivista potentiaalia, koska elektronit vetäytyvät katodille ja maadoitetaan anodilla, mikä luo sähkökentän kammion poikki. Positiivisesti varautunut plasma kiihtyy kohti katodisidosta substraattia syövyttäen sen tehokkaasti.
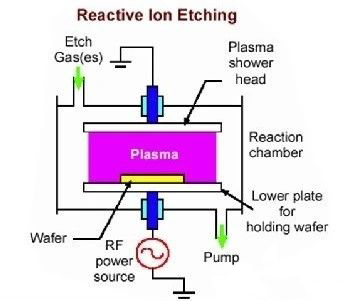
Syövytysprosessin aikana kammio ylläpitää matalapaineista ympäristöä (0,1-10 Pa), mikä lisää reaktiokaasujen ionisaationopeutta ja nopeuttaa kemiallista reaktioprosessia alustan pinnalla. Yleensä RIE-prosessi edellyttää, että reaktion sivutuotteet ovat haihtuvia, jotta ne voidaan poistaa tehokkaasti tyhjiöjärjestelmällä, mikä varmistaa korkean etsaustarkkuuden. RF-tehotaso määrittää suoraan plasman tiheyden ja kiihtyvyyden esijännitteen, mikä säätelee etsausnopeutta. Samalla kun RIE kuitenkin lisää plasman tiheyttä, se lisää myös esijännitettä, mikä voi aiheuttaa hilavaurioita ja vähentää maskin selektiivisyyttä, mikä rajoittaa etsaussovelluksia. Laajamittaisten integroitujen piirien nopean kehityksen ja transistorien koon pienentymisen myötä tarkkuus- ja kuvasuhteiden kysyntä on kasvanut mikro- ja nanovalmistuksessa, mikä on johtanut korkeatiheyksisten plasmapohjaisten kuivaetsaustekniikoiden käyttöön. uusia mahdollisuuksia sähköisen tietotekniikan kehittämiseen.
3. Elektronisyklotroniresonanssi (ECR) -plasmaetsaus
ECR-tekniikka, varhainen menetelmä korkeatiheyksisen plasman saavuttamiseksi, käyttää mikroaaltoenergiaa resonoidakseen elektronien kanssa kammion sisällä, ja sitä tehostaa ulkoisesti käytetty, taajuussovitettu magneettikenttä elektronisyklotroniresonanssin indusoimiseksi. Tällä menetelmällä saavutetaan huomattavasti korkeammat plasmatiheydet kuin RIE:llä, mikä parantaa etsausnopeutta ja maskin selektiivisyyttä, mikä helpottaa erittäin korkean kuvasuhteen rakenteiden syövytystä. Kuitenkin järjestelmän monimutkaisuus, joka perustuu mikroaaltolähteiden, RF-lähteiden ja magneettikenttien koordinoituun toimintaan, asettaa toiminnalle haasteita. ICP (Inductively Coupled Plasma) -etsauksen ilmaantuminen seurasi pian ECR:n yksinkertaistamisena.
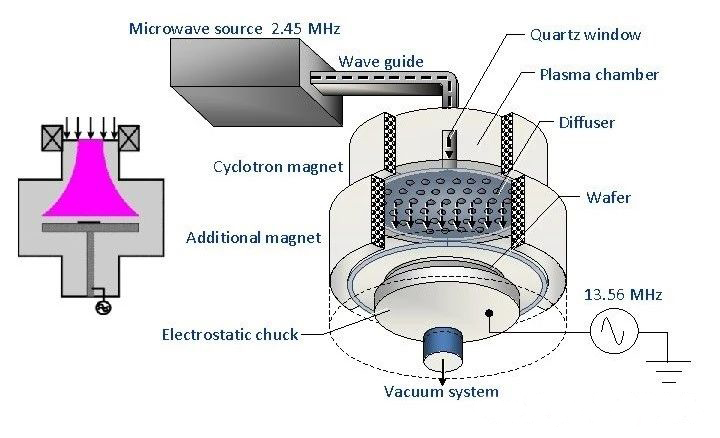
4. Induktiivisesti kytketty plasma (ICP) etsaus
ICP-etsaustekniikka yksinkertaistaa ECR-tekniikkaan perustuvaa järjestelmää käyttämällä kahta 13,56 MHz:n RF-lähdettä sekä plasman tuotannon että kiihdytyksen esijännitteen ohjaamiseen. ECR:ssä käytetyn ulkoisen magneettikentän sijaan spiraalikela indusoi vaihtuvan sähkömagneettisen kentän, kuten kaaviossa näkyy. RF-lähteet siirtävät energiaa sähkömagneettisen kytkennän kautta sisäisiin elektroneihin, jotka liikkuvat syklotroniliikkeessä indusoidussa kentässä ja törmäävät reaktiokaasuihin aiheuttaen ionisaation. Tällä asetuksella saavutetaan plasman tiheydet, jotka ovat verrattavissa ECR:ään. ICP-etsaus yhdistää eri etsausjärjestelmien edut, sillä se täyttää korkean etsausnopeuksien, korkean selektiivisyyden, laajan alueen tasaisuuden ja yksinkertaisen, ohjattavan laiterakenteen vaatimukset, joten siitä tulee nopeasti suositeltu valinta uuden sukupolven suuritiheyksisille plasmaetsaustekniikoille. .
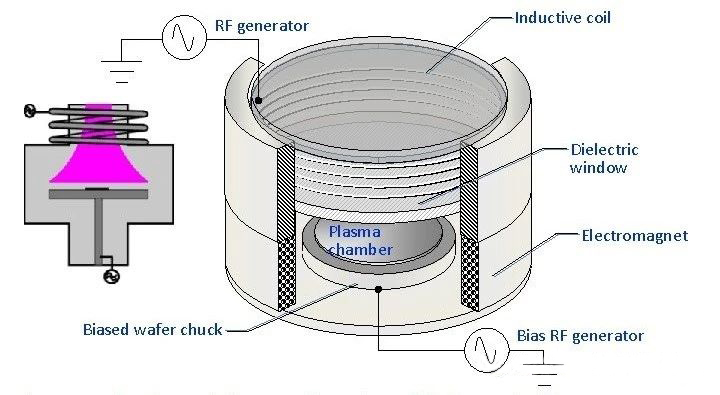
5. Kuivaetsauksen ominaisuudet
Kuivaetsaustekniikka on nopeasti ottanut pääaseman mikro- ja nanovalmistuksessa ylivoimaisen anisotropiansa ja korkeiden etsausnopeuksiensa ansiosta, mikä korvaa märkäetsauksen. Hyvän kuivasyövytystekniikan arviointikriteereitä ovat maskin selektiivisyys, anisotropia, etsausnopeus, yleinen tasaisuus ja pinnan sileys hilavaurioiden vuoksi. Monilla arviointikriteereillä konkreettinen tilanne on otettava huomioon valmistustarpeiden perusteella. Suorimmat kuivaetsauksen indikaattorit ovat pinnan morfologia, mukaan lukien syövytetyn lattian ja sivuseinien tasaisuus sekä syövytettyjen terassien anisotropia, joita voidaan molempia hallita säätämällä kemiallisten reaktioiden suhdetta fyysiseen pommitukseen. Mikroskooppinen karakterisointi syövytyksen jälkeen suoritetaan tyypillisesti pyyhkäisyelektronimikroskoopilla ja atomivoimamikroskopialla. Maskin selektiivisyys, joka on maskin etsaussyvyyden suhde materiaalin etsaussyvyyteen samoissa etsausolosuhteissa ja -ajassa, on ratkaisevan tärkeää. Yleensä mitä korkeampi selektiivisyys, sitä parempi on kuvion siirron tarkkuus. Yleisiä ICP-etsauksessa käytettyjä maskeja ovat fotoresistit, metallit ja dielektriset kalvot. Fotoresistillä on huono selektiivisyys ja se voi hajota korkeissa lämpötiloissa tai voimakkaassa pommituksessa; metallit tarjoavat korkean selektiivisyyden, mutta ne aiheuttavat haasteita maskin poistamisessa ja vaativat usein monikerroksisia maskaustekniikoita. Lisäksi metallinaamarit voivat tarttua sivuseiniin etsauksen aikana muodostaen vuotoreittejä. Siksi oikean maskitekniikan valinta on erityisen tärkeää etsauksen kannalta, ja maskimateriaalien valinta tulee määrittää laitteiden erityisten suorituskykyvaatimusten perusteella.**




