
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
Plasmaprosessit CVD-operaatioissa
1. Kammion puhdistus
Chemical Vapor Deposition (CVD) -prosessin aikana kerrostumat muodostuvat paitsi kiekon pinnalle myös prosessikammion ja sen seinien sisällä oleville komponenteille. Osiin kerrostuneet kalvot on poistettava säännöllisesti, jotta prosessiolosuhteet säilyvät vakaana ja vältetään kiekkojen hiukkaskontaminaatio. Useimmat CVD-kammiot käyttävät fluoripohjaisia kemiallisia reaktiokaasuja puhdistukseen.
Piioksidi-CVD-kammioissa plasmapuhdistukseen käytetään tyypillisesti fluorihiilikaasuja, kuten CF4, C2F6 ja C3F8, jotka hajoavat plasmassa vapauttaen fluoriradikaaleja. Kemialliset reaktiot esitetään seuraavasti:
·e- + CF4 -> CF3 + F + e-
· e- + C2F6 -> C2F5 + F + e-
Fluoriatomit, jotka ovat reaktiivisimpia radikaaleja, reagoivat nopeasti piioksidin kanssa muodostaen kaasumaista SiF4:ää, joka voidaan helposti poistaa kammiosta:
·F + SiO2 -> SiF4 + O2 + muut haihtuvat sivutuotteet
Volframi-CVD-kammiot käyttävät tyypillisesti SF6:ta ja NF3:a fluorin lähteinä. Fluoriradikaalit reagoivat volframin kanssa tuottaen haihtuvaa volframiheksafluoridia (WF6), joka voidaan poistaa kammiosta tyhjiöpumppujen kautta. Plasmakammion puhdistus voidaan lopettaa automaattisesti tarkkailemalla plasman fluorin emissioominaisuuksia välttäen kammion liiallista puhdistamista. Näitä näkökohtia käsitellään tarkemmin.
2. Aukkojen täyttö
Kun metalliviivojen välinen rako kapenee 0,25 µm:iin kuvasuhteella 4:1, useimmat CVD-pinnoitustekniikat eivät pysty täyttämään aukkoja ilman tyhjiä paikkoja. High-Density Plasma CVD (HDP-CVD) pystyy täyttämään tällaiset kapeita aukkoja luomatta tyhjiä paikkoja (katso alla oleva kuva). HDP-CVD-prosessi kuvataan myöhemmin.
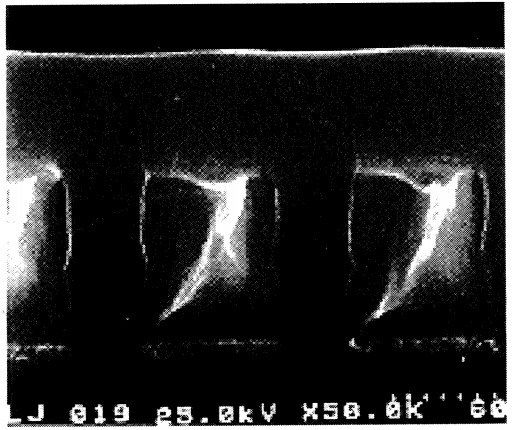
3. Plasmaetsaus
Märkäsyövytykseen verrattuna plasmaetsaus tarjoaa etuja, kuten anisotrooppiset etsausprofiilit, automaattisen päätepisteen havaitsemisen ja alhaisemman kemikaalien kulutuksen sekä kohtuullisen suuret etsausnopeudet, hyvän selektiivisyyden ja tasaisuuden.
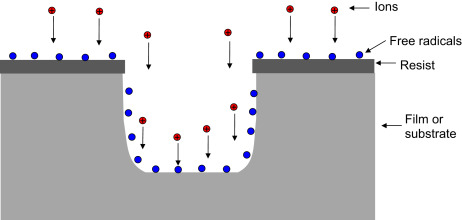
4. Etch-profiilien hallinta
Ennen kuin plasmaetsaus tuli laajalle levinneeksi puolijohteiden valmistuksessa, useimmat kiekot käyttivät märkäkemiallista etsausta kuvion siirtoon. Märkäsyövytys on kuitenkin isotrooppinen prosessi (etsaus samalla nopeudella joka suuntaan). Kun piirteiden koot kutistuvat alle 3 µm, isotrooppinen syövytys johtaa alileikkaukseen, mikä rajoittaa märkäetsauksen käyttöä.
Plasmaprosesseissa ionit pommittavat jatkuvasti kiekon pintaa. Plasmasyövytys voi saavuttaa anisotrooppisia etsausprofiileja joko hilavauriomekanismien tai sivuseinän passivointimekanismien avulla. Pienentämällä painetta etsausprosessin aikana, ionien keskimääräistä vapaata reittiä voidaan lisätä, mikä vähentää ionien törmäyksiä paremman profiilin hallinnan saavuttamiseksi.
5. Syövytysnopeus ja selektiivisyys
Plasman ionipommitus auttaa katkaisemaan pinta-atomien kemiallisia sidoksia ja altistaa ne plasman synnyttämille radikaaleille. Tämä fysikaalisen ja kemiallisen käsittelyn yhdistelmä parantaa merkittävästi syövytyksen kemiallista reaktionopeutta. Syövytysnopeus ja selektiivisyys määräytyvät prosessin vaatimusten mukaan. Koska sekä ionipommituksella että radikaaleilla on ratkaiseva rooli syövytyksessä ja RF-teho voi hallita ionipommitusta ja radikaaleja, RF-tehosta tulee keskeinen parametri etsausnopeuden säätelyssä. RF-tehon lisääminen voi merkittävästi parantaa etsausnopeutta, jota käsitellään tarkemmin, mikä vaikuttaa myös selektiivisyyteen.
6. Päätepisteen tunnistus
Ilman plasmaa syövytyksen päätepiste on määritettävä ajan tai käyttäjän silmämääräisen tarkastuksen perusteella. Plasmaprosesseissa, kun etsaus etenee pintamateriaalin läpi ja aloittaa etsauksen alla olevan (päätepisteen) materiaalin, plasman kemiallinen koostumus muuttuu syövytyksen sivutuotteissa tapahtuvan muutoksen vuoksi, mikä ilmenee emissiovärin muutoksesta. Tarkkailemalla säteilyn värin muutosta optisilla antureilla etsauksen loppupiste voidaan käsitellä automaattisesti. IC-tuotannossa tämä on erittäin arvokas työkalu.**




